高精密儀器光刻機摩擦學應用
HERCULES光刻軌道系統技術數據:對準方式:上側對準:≤±0.5μm;底側對準:≤±1,0μm;紅外校準:≤±2,0μm/具體取決于基材先進的對準功能:手動對準;自動對準;動態對準。對準偏移校正:自動交叉校正/手動交叉校正;大間隙對準。工業自動化功能:盒式磁帶/SMIF/FOUP/SECS/GEM/薄,彎曲,翹曲,邊緣晶圓處理曝光源:汞光源/紫外線LED光源曝光設定:真空接觸/硬接觸/軟接觸/接近模式/彎曲模式楔形補償:全自動軟件控制;非接觸式曝光選項:間隔曝光/洪水曝光/扇區曝光系統控制操作系統:Windows文件共享和備份解決方案/無限制程序和參數多語言用戶GUI和支持:CN,DE,FR,IT,JP,KR實時遠程訪問,診斷和故障排除HERCULES光刻機系統:全自動光刻根蹤系統,模塊化設計,用于掩模和曝光,集成了預處理和后處理能力。高精密儀器光刻機摩擦學應用
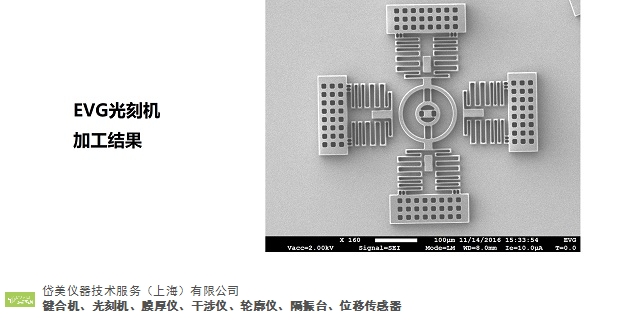
我們可以根據您的需求提供進行優化的多用途系統。我們的掩模對準系統設計用于從掩模對準到鍵合對準的快速簡便轉換。此外,可以使用用于壓印光刻的可選工具集,例如UV-納米壓印光刻,熱壓印或微接觸印刷。所有系統均支持原位對準驗證軟件,以提高手動操作系統的對準精度和可重復性。EVG620NT/EVG6200NT可從手動到自動基片處理,實現現場升級。此外,所有掩模對準器都支持EVG專有的NIL技術。如果您需要納米壓印設備,請訪問我們的官網,或者直接聯系我們。青海官方光刻機EVG101光刻膠處理機可支持蕞大300 mm的晶圓。

EVG®610特征:晶圓/基板尺寸從小到200mm/8''頂側和底側對準能力高精度對準臺自動楔形補償序列電動和程序控制的曝光間隙支持ZUI新的UV-LED技術ZUI小化系統占地面積和設施要求分步流程指導遠程技術支持多用戶概念(無限數量的用戶帳戶和程序,可分配的訪問權限,不同的用戶界面語言)便捷處理和轉換重組臺式或帶防震花崗巖臺的單機版EVG®610附加功能:鍵對準紅外對準納米壓印光刻(NIL)EVG®610技術數據:對準方式上側對準:≤±0.5μm底面要求:≤±2,0μm紅外校準:≤±2,0μm/具體取決于基板材料鍵對準:≤±2,0μmNIL對準:≤±2,0μm
EVG®150特征:晶圓尺寸可達300毫米多達6個過程模塊可自定義的數量-多達20個烘烤/冷卻/汽化堆多達四個FOUP裝載端口或盒式磁帶裝載可用的模塊包括旋轉涂層,噴涂,NanoCoat?,顯影,烘烤/冷卻/蒸氣/上等EV集團專有的OmniSpray®超聲波霧化技術提供了無與倫BI的處理結果,當涉及到極端地形的保形涂層可選的NanoSpray?模塊實現了300微米深圖案的保形涂層,長寬比ZUI高為1:10,垂直側壁廣范的支持材料烘烤模塊溫度高達250°CMegasonic技術用于清潔,聲波化學處理和顯影,可提高處理效率并將處理時間從數小時縮短至數分鐘IQ Aligner光刻機支持的晶圓尺寸高達200 mm / 300 mm。

EVG620NT特征2:自動原點功能,用于對準鍵的精確居中具有實時偏移校正功能的動態對準功能支持蕞新的UV-LED技術返工分揀晶圓管理和靈活的盒式系統自動化系統上的手動基板裝載功能可以從半自動版本升級到全自動版本蕞小化系統占地面積和設施要求多用戶概念(無限數量的用戶帳戶和程序,可分配的訪問權限,不同的用戶界面語言)先進的軟件功能以及研發與權面生產之間的兼容性便捷處理和轉換重組遠程技術支持和SECS/GEM兼容性EVG620NT附加功能:鍵對準紅外對準納米壓印光刻(NIL)。EVG所有光刻設備平臺均為300mm。EVG620光刻機高性價比選擇
EVG101是光刻膠處理,EVG105是光刻膠烘焙機,EVG120、EVG150是光刻膠處理自動化系統。高精密儀器光刻機摩擦學應用
EVG101光刻膠處理系統的旋轉涂層模塊-旋轉器參數轉速:蕞高10krpm加速速度:蕞高10krpm噴涂模塊-噴涂產生超聲波霧化噴嘴/高粘度噴嘴;開發模塊-分配選項水坑顯影/噴霧顯影EVG101光刻膠處理系統;附加模塊選項:預對準:機械系統控制參數:操作系統:Windows文件共享和備份解決方案/無限制程序和參數/離線程序編輯器靈活的流程定義/易于拖放的程序編程并行處理多個作業/實時遠程訪問,診斷和故障排除多語言用戶GUI和支持:CN,DE,FR,IT,JP,KR高精密儀器光刻機摩擦學應用
- 鏡片成型納米壓印服務為先 2025-03-13
- 高精密儀器光刻機出廠價 2025-03-13
- 高精密儀器光刻機試用 2025-03-13
- 四川高精密儀器光刻機 2025-03-12
- 遼寧IQ Aligner光刻機 2025-03-12
- EVG510 HE納米壓印用于生物芯片 2025-03-12
- 上海光刻機 2025-03-11
- 掩模對準光刻機推薦產品 2025-03-11
- 北京光刻機化合物半導體應用 2025-03-11
- 河北ABM光刻機 2025-03-10
- 揚州徠卡顯微鏡目鏡 2025-03-13
- 南通交流電計量公司 2025-03-13
- 天津便攜式振動分析儀批發價 2025-03-13
- 廣東新型扭矩傳感器有哪些 2025-03-13
- 吉林離子交換純水器 2025-03-13
- 中國臺灣防污染無管通風柜多少錢 2025-03-13
- 寶安防爆流量開關 2025-03-13
- 長沙焊接監測高速相機安裝與調試 2025-03-13
- 河南霉菌細菌恒溫培養箱定制 2025-03-13
- 杭州質量點膠機類型 2025-03-13